

유기 하드마스크 도입 배경
반도체 미세화에 따른 패턴 형성을 위해서는 Photoresist 두께가 점점 감소하게 됨
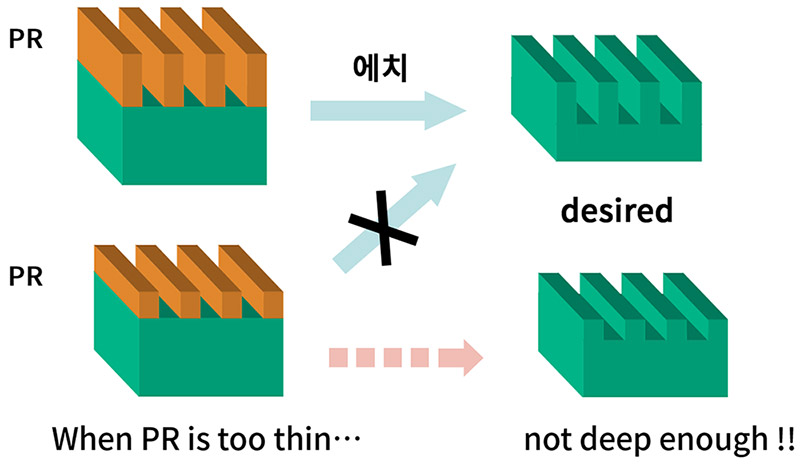
유기하드마스크 정의
· 반도체 패터닝 공정에서 Photoresist 하부에 도입되어 후속
· 에칭 공정에서 에치방어막(hardmask) 역할로 도입되는 유기 탄소 코팅막 소재

High aspect ratio → “line collapse”
Low aspect ratio → “stable pattern”
PR이 얇아 지면, PR 만으로는
패턴 전사가 어려워짐
에칭 시 무기 ACL 막질 사용
· 설비/공정 제조 비용이 넘 많이 소요
· 공정시간이 넘 길며, 파티클 문제 발생
· 후막 ACL 대체 소재 필요!!
Organic Hardmask 필요!!
정의
· 반도체 패터닝 공정에서 Photoresist 하부에 도입되어 후속
에칭 공정에서 에치방어막(hardmask) 역할로 도입되는 유기 탄소 코팅막 소재
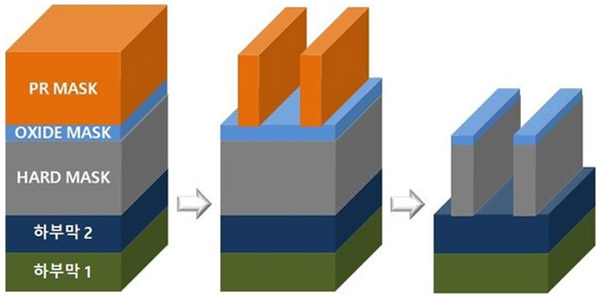
유기 하드 마스크 모식도


High Etch SOH :
Thickness 1,000~2,000Å
High carbon contents (Carbon content > 91%)
High film density
Low out-gassing properties (No embossing)
Good coating uniformity

High Thickness SOH :
Thickness 5,000~10,000Å
Good soluble polymer (No clogging)
High etch resistance
Good coating uniformity (No crack)

High Temp. SOH :
Thickness 1,000~3,000Å
Good thermal stability (weight loss < 10% @500℃)
High etch resistance
Good coating uniformity (No crack)
